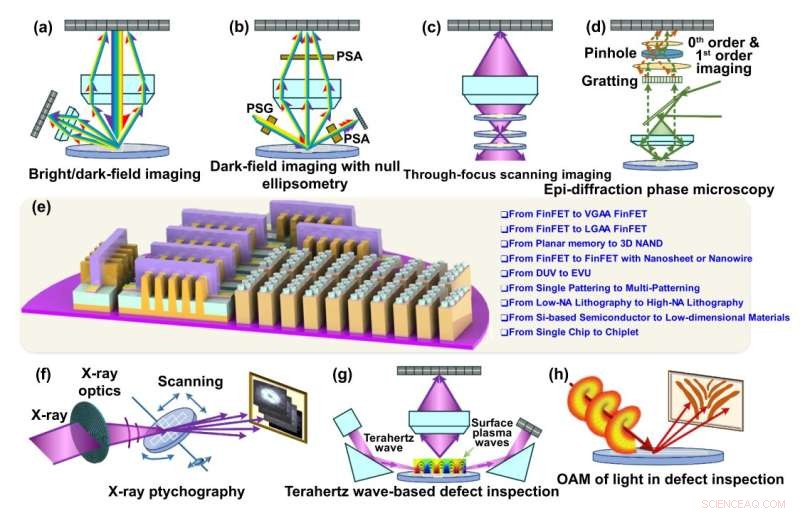
Olika inspektionssystem för optiska waferdefekter inklusive (a) ljusfälts-/mörkfältsavbildningssystem, (b) mörkfältsavbildning med nollellipsometri, (c) skanningsmikroskopi med genomskärning, (d) epi-diffraktionsfasmikroskopi, (e) mönstrad wafer som innehåller logiska matriser och 3D NAND-minnesformar, (f) röntgenptykografi, (g) THz-vågbaserat defektinspektionssystem och (h) Koherent Fourier-scatterometritekniker med användning av olika OAM-belysningsstrålar. Kredit:Av Jinlong Zhu et al.
Defektinspektionsforskare från Huazhong University of Science and Technology, Harbin Institute of Technology och The Chinese University of Hong Kong gör en grundlig genomgång av nya perspektiv och spännande trender på grunden av tidigare stora recensioner inom området för defektinspektionsmetoder. Granskningen fokuserar på tre specifika områden:(1) utvärderingen av defektdetekterbarhet, (2) de olika optiska inspektionssystemen och (3) efterbehandlingsalgoritmerna.
Publicering i tidskriften International Journal of Extreme Manufacturing , Nanoscale and Optical Metrology Research Center (NOMRC) ledd av Prof. Shiyuan Liu och Prof. Jinlong Zhu från Huazhong University of Science and Technology och deras medarbetare från Harbin Institute of Technology och The Chinese University of Hong Kong skrev den första systematiska översikten till introducera forskningsbakgrunden, diskutera de senaste framstegen och trenden med inspektion av optiska waferdefekter. Denna recension har avslöjat att banbrytande tekniker som nanofotonik, optiska virvlar, beräkningsavbildning, kvantitativ fasavbildning och djupinlärning kan ha en djupgående inverkan på inspektion av defekter under 10 nm. Arbetet kan bana nya vägar för området för inspektion av defekter av halvledarskivor.
Prof. Jinlong Zhu och Prof. Shiyuan Liu säger att "de ständigt krympande egenskaperna och utrymmet på mönstrade wafers skulle dramatiskt belasta kapaciteten hos alla nuvarande metrologi- och inspektionslösningar för att balansera känslighet, specificitet, processhastighet och fångsthastighet."
Optisk waferinspektion förblir en av arbetshästarna för defektinspektion i fabriken. I ett konventionellt defektinspektionsverktyg fångas defekterna genom att jämföra kretsmönsterbilder av intilliggande formar. Den första författaren till översiktsartikeln, professor Jinlong Zhu säger att "nyckeln till defektinspektion är inte upplösning, utan signal-brusförhållandet (SNR) och kontrast. Förbättringen av SNR och kontrast beror mycket på sofistikerade instrument, avancerade modelleringsarkitekturer och efterbearbetningsalgoritmer, som alla fick oss att göra en omfattande översyn av metoder för upptäckt av waferdefekter utifrån följande tre aspekter:(1) utvärderingen av defektdetekterbarheten, (2) de olika optiska inspektionssystemen och (3 ) efterbehandlingsalgoritmerna."
"Det är av stor vikt att utföra detekterbarhetsbedömning för en specifik typ av inspektionsverktyg för avancerade noder," förklarade medförfattaren Dr. Jiamin Liu. "Faktum är att utvärderingen av defektdetekterbarhet vanligtvis innefattar formuleringen av kvantitativa regler för SNR för defektspridningssignalerna, utveckling av simuleringsverktyg för defektspridningssignalmodellering och analys av defekt-SNR. Vi fann att defektens SNR beror avsevärt på om material- och defekttopologi."
De konventionella tillvägagångssätten för optisk defektinspektion, såsom den amplitudbaserade tillsammans med dess efterbehandlingsalgoritmer, har diskuterats grundligt. De nya inspektionsmekanismerna inklusive fas-, orbital vinkelmomentum-, terahertz-våg- och hyperboliska Bloch-lägesbaserade, har lyfts fram för att påminna läsarna om deras potential att öppna nya riktningar inom området. Dessutom har röntgenptykografi, den enda optiska metoden som direkt kan avbilda både yt- och underytadefekter under 20 nm för hela wafern, också granskats och prospekterats i detalj i artikeln. Röntgenptykografi har potential att penetrera fältet genom att tillhandahålla revolutionerande 3D-upplösning och känslighet när nackdelarna inklusive synkrotronröntgenljuskällan, en enorm mängd data och den låga hastigheten kommer att erövras i framtiden.
"Oavsett om det är den enklaste bildskillnadsoperatorn eller den komplexa bildsyntetiska algoritmen eller till och med algoritmerna för djupinlärning, spelar dessa efterbehandlingsalgoritmer en avgörande roll vid inspektion av optiska defekter när det gäller att förbättra SNR och kontrasten för defekter. Därför tillhandahåller vi en detaljerad diskussion om efterbearbetningsalgoritmer involverade i inspektion av mönstrade waferdefekter med ett specifikt fokus på fördelarna och nackdelarna med algoritmer för djupinlärning," tillade den första författaren Dr. Tianlai Xu vidare.
Prof. Jinlong Zhu säger att de "tror att inspektion av optiska defekter på mönstrade wafers kommer att förbli ett utmanande men intressant ämne som snarast måste tas upp. Vi tror att den här översiktsartikeln, som är skriven på grundval av tidigare recensioner och viss explorativ forskning i framkant, är viktigt för både nya aktörer inom området och de som vill använda det i tvärvetenskapligt arbete." + Utforska vidare