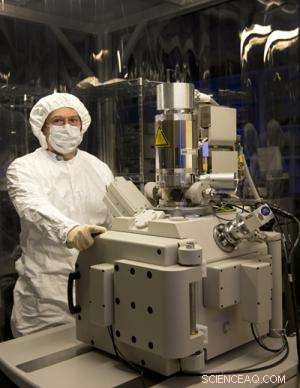
Dr. András Vladár driver NIST dimensionella metrologiska referens scanning elektronmikroskop.
(Phys.org) – PML-forskare har tagit fram en idé för att bestämma den tredimensionella formen av funktioner så små som 10 nanometer breda. Den modellbaserade metoden jämför data från svepelektronmikroskopbilder (SEM) med lagrade poster i ett bibliotek med tredimensionella (3D) former för att hitta en matchning och för att bestämma formen på provet. Arbetet ger ett kraftfullt nytt sätt att karakterisera nanostrukturer.
SEM används ofta inom olika industri- och vetenskapsområden eftersom det är ett av de mest mångsidiga bild- och mätinstrumenten. Storleken och formen på strukturer i nanometerskala är viktig information att känna till, speciellt för tillverkning av integrerade kretsar (IC) och funktioner i nanoskala. SEM, med bättre än 1 nanometer upplösning, ger information om dessa strukturer som vanligtvis tolkas som tvådimensionella (2D) bilder. Men dessa bilder innehåller en mängd information relaterad till alla tre dimensionerna, och PML-forskarna satte sig för att fånga det.
I början av detta arbete, det fanns två hinder för att uppnå mycket hög noggrannhet, den ena påverkar kvaliteten på mätningarna och den andra tolkningen:(1) bild- och mätkvaliteten försämras genom drift av provet och elektronstrålen, eftersom även små rörelser resulterar i förvrängda bilder, och (2) korrekt tolkning av SEM-resultat kräver en korrekt, fysikbaserad modell av förhållandet mellan 3D-provets geometri och intensiteten hos signalen som används för att förvärva bilderna.
För att övervinna dessa hinder, ett team ledd av András E. Vladár från PML:s Semiconductor and Dimensional Metrology Division utvecklade framgångsrikt en modellbaserad mätmetod som rekonstruerar 3D-formen och som för första gången framgångsrikt tillämpade den på strukturer i 10 nanometerskala. De har utvecklat två program:en snabb bildinsamlingsmetod som kan kompensera för den oundvikliga prov- och elektronstråledriften; och en Monte Carlo-simuleringsbaserad metod för att tolka 2D-bilderna i 3D.
Den första programvaran, kallas ACCORD, arbetar med 2D Fourier-transformers för att sätta ihop många snabbt förvärvade bilder, ungefär på samma sätt som astronomer kan fånga bilder av stjärnor utan suddighet eller andra förvrängningar. Resultatet är en enda driftfri bild, en mycket närmare sann representation av provet än någon bild som tillhandahålls med traditionella metoder.
När en bild av god kvalitet har satts ihop, en Monte Carlo-modelleringsprogramvara (JMONSEL), utvecklad av John Villarrubia från PML, används för att generera ett bibliotek av SEM-vågformer för 3D-strukturer med formparametrar (t.ex. bredder, vinklar, krökningsradier) som spänner över ett intervall av värden runt de förväntade. Smala strukturer som det senaste arbetet har 10 nm linjer som ställer större krav på modellen eftersom spridda elektroner kan komma ut från flera ytor (t.ex. vänster, höger, och överst) samtidigt. Efter att ha genererat ett bibliotek av SEM-vågformer, uppgiften är att identifiera eventuella 3D-former med modellerade bilder som passar den förvärvade bilden. Resultatet kan renderas till en 3D-representation av provformen.
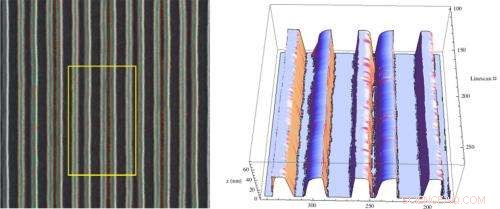
En SEM-bild av ett IC-prov med 10 nm breda SiO2-linjer, med botten- och överkant markerade röda respektive gröna (vänster). Området markerat med en gul ram som återges till en 3D-plot (höger).
Tillämpningen av dessa metoder för SEM-avbildning och 3D-modellering på 10 nm-nivå, och kvaliteten på resultaten, utgör en första prestation i världen. Den nya metoden är så kraftfull att i detta enkla fall av en IC-struktur, en enda bild uppifrån och ned kan räcka för att bestämma 3D-formen tillsammans med provdetaljer i nanometerskala.
Forskarna testade sina resultat mot mätningar från ett transmissionselektronmikroskop (TEM) på 10 nm IC-linjer. Skillnaden var mindre än en nanometer - så liten som bara några få atomer. SEM-resultaten överensstämde också väl med resultaten av röntgenspridningsmätningar med liten vinkel av kritisk dimension.
"Det finns ingen enskild metod i världen som kan ge dig alla svar, " förklarar Vladár. "Men, när två eller tre metoder ger dig samma mätresultat, ditt förtroende för det resultatet är mycket högre."
Samarbete med ingenjörer från Intel Corp. var avgörande för studien eftersom de kunde förse NIST med lämpliga prover.
"Vi har utvecklat en metod som i sin nuvarande form, kan användas av i stort sett alla som har ett lämpligt svepelektronmikroskop, " säger Vladár. Även om denna teknik är i början, resultaten visar tydligt att 3D SEM-mätningar på nanometernivå är ett viktigt tillägg till de befintliga metoderna, som alla är viktiga för mätning på nanometernivå.
PML-forskare kommer att ytterligare förbättra tekniken genom att fokusera på att förbättra modelleringsmjukvaran, vilket inte är tillräckligt snabbt just nu.
"För närvarande, flaskhalsen är hastigheten, " säger Vladár. "Att generera de modellerade biblioteken kan ta lång tid. Tolkningen av data - att hitta den bästa 3D-matchningen - går också långsamt för närvarande."
Ytterligare studier kommer att utforska sätt att hantera bilder tagna från olika vinklar, vilket kommer att vara nödvändigt vid 3D-modellering av nanopartiklar. Denna studie använde endast bilder uppifrån och ner. Nya metoder kommer att behövas för att slå samman flera vyer till en enda, exakt 3D-representation av prover med strukturer som inte är tydligt synliga från endast en vy.
Till sist, de planerar att undersöka möjligheten att använda tekniken för att modellera funktioner som är ännu mindre än 10 nm.
"Vi har stora förhoppningar om att den här metoden kommer att fungera bra i 5 till 7 nm-området, ", säger Vladár. "Vi har redan idéer om hur vi kan driva tekniken ytterligare.
"Denna 3D-teknik förväntas påverka en mängd olika tekniker, allt från integrerad kretsproduktion till nanoteknik för 3D-karakterisering av nanostrukturer och nanopartiklar, kritisk för katalytiska och nanobiotillämpningar."