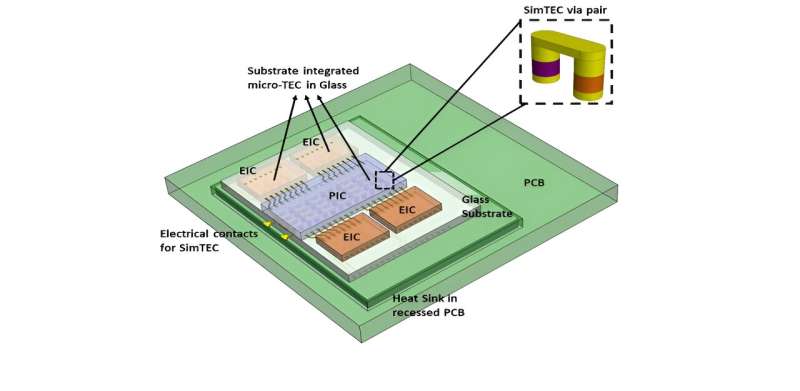
Fotonik erbjuder olika fördelar, inklusive möjliggörande av höghastighetskommunikation och lågförlustkommunikation genom att utnyttja ljusegenskaper i optisk datakommunikation, biomedicinska applikationer, fordonsteknologi och artificiell intelligensdomäner. Dessa fördelar realiseras genom komplexa fotoniska kretsar, som består av olika fotoniska element som är integrerade på ett fotoniskt chip.
Elektroniska chips läggs sedan till för att komplettera de fotoniska chipsen för vissa funktioner, såsom ljuskällasdrift, modulering och förstärkning. Den nära integrationen av elektroniska och fotoniska chips på ett substrat är en kritisk aspekt av fotoniska förpackningar.
Fotoniska förpackningar spelar en viktig roll för att stödja effektiv drift av elektroniska och fotoniska chips över elektriska, optiska, mekaniska och termiska domäner. Effektiv värmehantering blir avgörande i kompakta paket där termisk överhörning mellan elektroniska och fotoniska chips, tillsammans med omgivningstemperaturfluktuationer, kan påverka fotonchips prestanda negativt.
Glassubstrat, som diskuteras allmänt som en samförpackningsplattform för elektroniska och fotoniska chips, är kritiska här eftersom de erbjuder fördelar som kompakt formfaktor, låg elektrisk förlust och en tillverkningsbar plattform på panelnivå. Dessutom har glassubstrat låg värmeledningsförmåga, vilket underlättar minimal lateral värmespridning mellan elektroniska och fotoniska chips.
Inkorporeringen av genomgående glasvias (TGV) i glassubstrat möjliggör effektiv värmeavledning från elektroniska chips. En annan värmehanteringsstrategi innebär att integrera mikrotermoelektriska kylare (mikro-TEC) på undersidan av ett chip, vilket ger aktiv temperaturkontroll.
I ny forskning publicerad i Journal of Optical Microsystems , introduceras en kombination av TGV och mikro-TEC-tekniker som kallas "substratintegrerade mikrotermoelektriska kylare (SimTEC)".
SimTEC involverar TGV:er delvis fyllda med koppar och termoelektriska material, vilket säkerställer termisk stabilisering av fotoniska och elektroniska chips i paketet. Denna nya teknik kompletterar kylningsmetoder på systemnivå. Forskaren Parnika Gupta och kollegor vid University College Cork, Irland, undersökte inverkan av glassubstrat på den termiska prestandan hos segmenterade vior och jämförde den med den för de fristående mikro-TEC-pelarna. De analyserade effekten av via diameter, höjd, stigning och fyllningsfaktor på SimTEC:s kylprestanda.
Speciellt ger tekniken exakt termisk kontroll i förpackningen och minskar det termiska motståndet mellan TEC-ytan och chipgränssnittet när chips är flip-chip-bundna på glassubstratet. Simuleringar med design av experiment (DOE) indikerar en maximal kylning på 9,3 K eller ett temperaturstabiliseringsområde på 18,6 K.
Studien underströk också en sex gånger större variation i kylprestanda med variationen i via-geometri jämfört med kylprestandavariationen hos det fristående mikro-TEC-enkelelementet. Att optimera termoelektriska materialegenskaper har potentialen för att förbättra prestandan hos framtida SimTEC-integrerade arkitekturer.
Mer information: Parnika Gupta et al, Substrat integrerade mikrotermoelektriska kylare i glassubstrat för nästa generations fotoniska paket, Journal of Optical Microsystems (2024). DOI:10.1117/1.JOM.4.1.011006
Tillhandahålls av SPIE