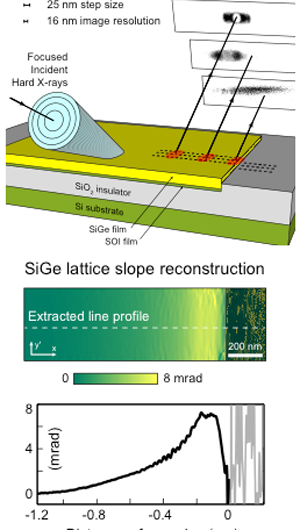
(Överst) Fokuserade strålsammanhängande röntgen-nanodiffraktionsmönster som samlats in från en SiGe-on-SOI-prototypenhetskant och (mitten och botten) projicerat stamfält rekonstruerat med ptychographic metoder.
(Phys.org) —Det teoretiska och experimentella ramverket för en ny koherent diffraktionsstamavbildningsstrategi utvecklades i Center for Nanoscale Materials X-Ray Microscopy Group i samarbete med Argonnes Material Science Division, tillsammans med användare från IBM. Nanofokuserad röntgen-Bragg-projektion ptychography skapar ett verktyg för att effektivt avbilda töjningsfält med oförstörda gränsförhållanden i teknologiskt och vetenskapligt relevanta energisystem.
Denna nya teknik kan avbilda gitterförvrängningar i tunna filmer icke -destruktivt vid rumsliga upplösningar av <20 nm med hjälp av koherenta nanofokuserade hårda röntgenstrålar. Detta arbete markerar ett betydande steg framåt i utvecklingen av icke-destruktiva koherenta röntgendiffraktionsteknik för studier av nanoskala gitterfunktioner i verkliga material under verkliga förhållanden. Den här studien, där strukturella subtiliteter löstes i en prototyp av enheter som härrör från både inneboende storlekseffekter och yttre gränsförhållanden, banar väg för icke -destruktiva studier av struktur i material i nanometerlängdskalor där förutsägelse, mått, och kontroll av töjning är svår.
De data som erhållits från det avbildade systemet användes för att bestämma gitterstamprofilen i ett epitaxiellt SiGe -stressskikt i en kiselprototypanordning. Mätning av stam från epitaxiala gitterfel och enhetsbehandling kan testa kontinuumelastiska modelleringsprognoser för nanoskala stamfördelningar.