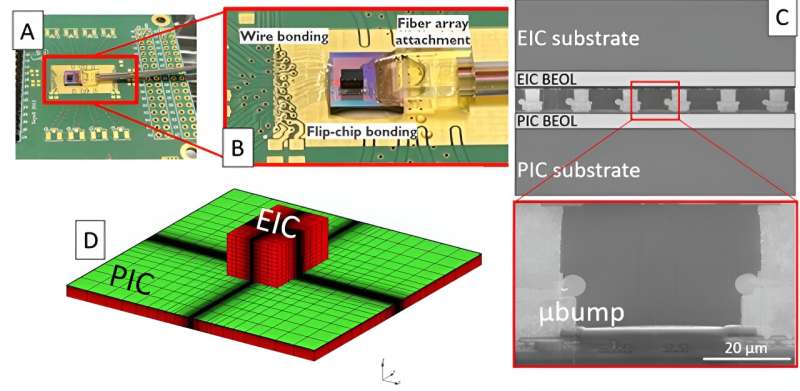
De senaste framstegen inom AI och mer specifikt stora språkmodeller som ChatGPT har satt en belastning på datacenter. AI-modeller kräver enorma mängder data för att träna, och för att flytta data mellan processorenheterna och minnet blir effektiva kommunikationslänkar nödvändiga.
För långdistanskommunikation har fiberoptik redan varit den bästa lösningen i årtionden. För kortdistanskommunikation inom datacenter börjar branschen nu också ta till sig fiberoptik på grund av dess utmärkta prestanda jämfört med klassiska elektriska länkar. Den senaste tekniska utvecklingen gör det nu till och med möjligt att byta från elektrisk till optisk sammankoppling för mycket små avstånd, såsom kommunikationen mellan chips i samma paket.
Detta kräver en omvandling av dataströmmen från den elektriska till den optiska domänen, vilket sker i den optiska transceivern. Kiselfotonik är den mest använda tekniken för att tillverka dessa optiska sändtagare.
De aktiva fotoniska enheterna inuti chippet (modulatorer och fotodetektorer) kräver fortfarande en anslutning med elektroniska drivrutiner för att driva enheterna och läsa inkommande data. Att stapla det elektroniska chippet (EIC) direkt ovanpå det fotoniska chippet (PIC) med hjälp av 3D-staplingsteknik realiserar en mycket tät integration av komponenterna med låg parasitisk kapacitans.
I forskning som nyligen publicerats i Journal of Optical Microsystems , undersöks den termiska effekten av denna 3D-integrering.
Designen av fotonchippet består av en rad ringmodulatorer, som är kända för sin temperaturkänslighet. För att kunna arbeta i en krävande miljö, såsom ett datacenter, behöver de aktiv termisk stabilisering. Detta implementeras i form av integrerade värmare. Av energieffektivitetsskäl är det uppenbart att den effekt som krävs för termisk stabilisering bör minimeras.
Forskargruppen från KU Leuven och Imec i Belgien mätte uppvärmningseffektiviteten hos ringmodulatorerna experimentellt före och efter flip-chip-bindningen av EIC på PIC. En relativ förlust på -43,3 % i effektivitet hittades, vilket är en betydande inverkan.
Dessutom tillskrev 3D finita element-simuleringar denna förlust till värmespridning i EIC. Denna värmespridning bör undvikas eftersom, i det ideala fallet, all värme som genereras i den integrerade värmaren finns nära den fotoniska enheten. Den termiska överhörningen mellan de fotoniska enheterna ökade också med upp till +44,4 % efter bindning av EIC, vilket komplicerade den individuella termiska kontrollen.
Att kvantifiera den termiska effekten av 3D fotonisk-elektronisk integration är viktigt, men det är också förhindrandet av värmarens effektivitetsförlust. Av denna anledning genomfördes en termisk simuleringsstudie där typiska designvariabler ändrades med målet att öka värmarens effektivitet. Det har visat sig att genom att öka avståndet mellan µbumps och den fotoniska enheten och genom att minska sammankopplingens linjebredd, kan den termiska straffen för 3D-integrering minimeras.
Mer information: David Coenen et al, Termisk modellering av hybrid tredimensionella integrerade, ringbaserade fotoniska-elektroniska sändtagare av kisel, Journal of Optical Microsystems (2023). DOI:10.1117/1.JOM.4.1.011004
Tillhandahålls av SPIE